www.mexicoindustrial.net
01
'26
Written on Modified on
ZEISS mejora la precisión FIB-SEM con Crossbeam 750
El nuevo sistema combina imagen SEM en tiempo real y fresado FIB con óptica Gemini 4 para mejorar la precisión del punto final y los flujos de trabajo de análisis 3D.
www.zeiss.com
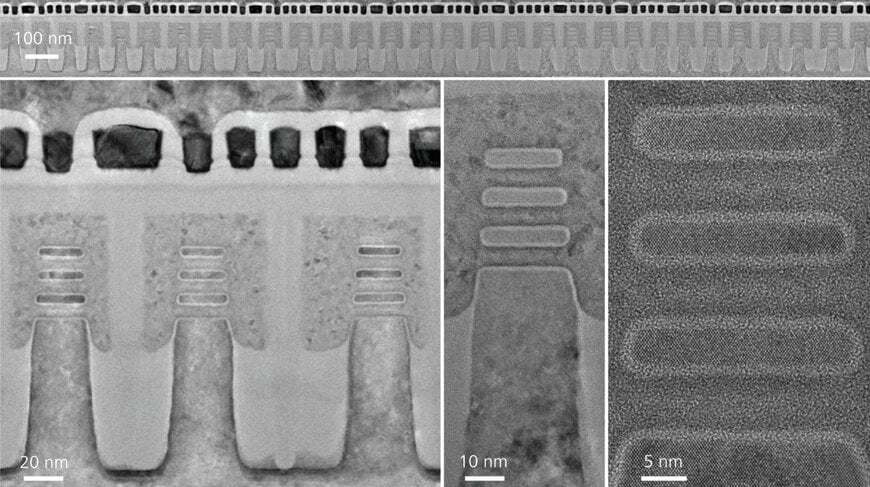
El análisis de semiconductores, la ciencia de materiales y los procesos de nanofabricación requieren una preparación de muestras precisa, imagen de alta resolución y una detección exacta del punto final a escala nanométrica. En este contexto, ZEISS ha presentado el Crossbeam 750 FIB-SEM, diseñado para permitir el fresado simultáneo con haz de iones enfocado (FIB) y la imagen mediante microscopía electrónica de barrido (SEM), garantizando un control continuo del proceso durante la preparación de muestras.
El sistema integra la imagen en tiempo real con las operaciones de fresado, permitiendo a los usuarios supervisar la eliminación de material y la evolución estructural sin interrumpir el proceso. Este enfoque aborda una limitación clave en los flujos de trabajo FIB-SEM convencionales, donde la imagen intermitente puede provocar imprecisiones en la detección del punto final y un aumento del retrabajo.
Control de proceso en tiempo real “ver mientras se fresa”
El Crossbeam 750 permite la imagen SEM continua en todas las condiciones de fresado, desde la eliminación de material a alta corriente hasta el pulido fino a bajos voltajes de aceleración de hasta 0,5 kV. Esta capacidad permite a los operadores observar directamente las interacciones FIB–muestra y ajustar los parámetros en tiempo real.
Este nivel de control es particularmente relevante en la preparación de láminas para microscopía electrónica de transmisión (TEM), donde se requiere un espesor uniforme y daños mínimos. Al mantener la visibilidad durante todo el proceso, el sistema respalda el éxito en el primer intento en la fabricación de láminas y reduce la necesidad de correcciones iterativas.
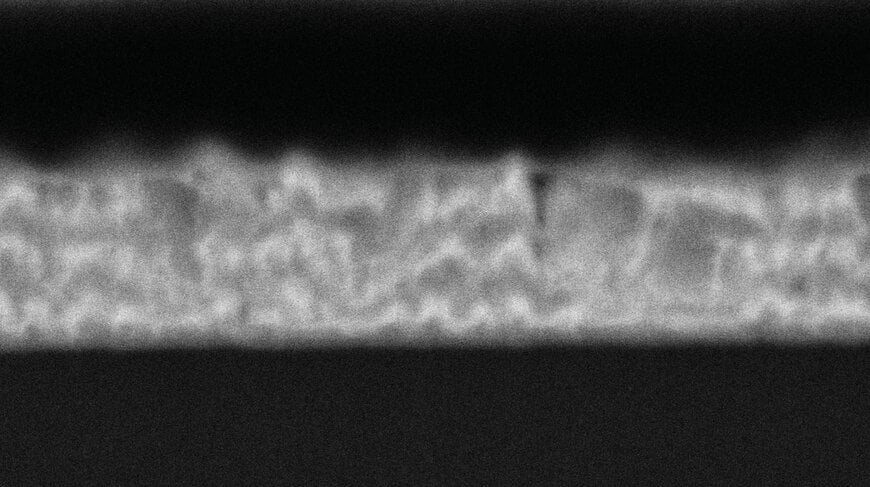
Óptica Gemini 4 para imagen de alta resolución
El sistema incorpora la nueva óptica electrónica Gemini 4, que proporciona una mejor resolución y una mayor relación señal-ruido. Esto permite una imagen libre de fondo y un rendimiento estable a bajas energías de aterrizaje, lo cual es fundamental para materiales sensibles y análisis de alta precisión.
El rendimiento de imagen mejorado respalda aplicaciones que requieren una caracterización estructural detallada, incluidos dispositivos semiconductores avanzados y sistemas de materiales a escala nanométrica.
Aplicaciones en flujos de trabajo avanzados de semiconductores y materiales
El Crossbeam 750 está diseñado para su uso en aplicaciones de semiconductores de nodos avanzados, incluidos dispositivos lógicos y de memoria basados en arquitecturas como gate-all-around (GAA) y FET complementarios (CFET). Estas estructuras requieren una precisión a escala nanométrica durante el seccionado y adelgazamiento de muestras.
Más allá de los semiconductores, el sistema admite una variedad de aplicaciones en ciencia de materiales y ciencias de la vida, incluyendo:
- Preparación de láminas TEM para microscopía de alta resolución
- Preparación de muestras para tomografía de sonda atómica (APT)
- Procesos de nanofabricación como la litografía por haz de electrones
- Imagen volumétrica tridimensional (3D) y tomografía
El gran campo de visión sin distorsión del sistema mejora la calidad de los datos en la tomografía 3D, mientras que las condiciones estables de imagen a bajo kV mejoran el contraste y reducen el tiempo de adquisición.

Mayor rendimiento y reproducibilidad
Al eliminar la necesidad de pausar el fresado para la imagen, el Crossbeam 750 optimiza los flujos de trabajo y reduce el tiempo total de procesamiento. La monitorización continua permite resultados más consistentes, especialmente en entornos de alto rendimiento donde la reproducibilidad es crítica.
La capacidad de alcanzar puntos finales precisos en el primer intento es especialmente valiosa en el análisis de fallos de semiconductores y el desarrollo de procesos, donde las desviaciones a escala nanométrica pueden afectar el rendimiento del dispositivo.
Posicionamiento dentro de los sistemas FIB-SEM
Las plataformas FIB-SEM se utilizan ampliamente para la preparación y el análisis de muestras a escala nanométrica. Sistemas comparables incluyen la serie Helios de Thermo Fisher Scientific y las plataformas FERA de Tescan, que también combinan el fresado por haz de iones con la imagen electrónica.
Los principales factores diferenciadores en este segmento incluyen la resolución de imagen a bajos voltajes, la visibilidad del proceso en tiempo real y la calidad del campo de visión para la reconstrucción 3D. La integración de imagen SEM continua durante el fresado y la óptica electrónica mejorada del Crossbeam 750 apunta a estos parámetros de rendimiento, especialmente para nodos semiconductores avanzados y la investigación de materiales de alta precisión.
Al combinar imagen y fresado simultáneos con un rendimiento óptico mejorado, el Crossbeam 750 responde a las necesidades en evolución en la fabricación y el análisis a escala nanométrica, donde el control del proceso y la fidelidad de imagen impactan directamente los resultados.
Editado por Natania Lyngdoh, Editora de Induportals — Adaptado por IA.
www.zeiss.com

Mayor rendimiento y reproducibilidad
Al eliminar la necesidad de pausar el fresado para la imagen, el Crossbeam 750 optimiza los flujos de trabajo y reduce el tiempo total de procesamiento. La monitorización continua permite resultados más consistentes, especialmente en entornos de alto rendimiento donde la reproducibilidad es crítica.
La capacidad de alcanzar puntos finales precisos en el primer intento es especialmente valiosa en el análisis de fallos de semiconductores y el desarrollo de procesos, donde las desviaciones a escala nanométrica pueden afectar el rendimiento del dispositivo.
Posicionamiento dentro de los sistemas FIB-SEM
Las plataformas FIB-SEM se utilizan ampliamente para la preparación y el análisis de muestras a escala nanométrica. Sistemas comparables incluyen la serie Helios de Thermo Fisher Scientific y las plataformas FERA de Tescan, que también combinan el fresado por haz de iones con la imagen electrónica.
Los principales factores diferenciadores en este segmento incluyen la resolución de imagen a bajos voltajes, la visibilidad del proceso en tiempo real y la calidad del campo de visión para la reconstrucción 3D. La integración de imagen SEM continua durante el fresado y la óptica electrónica mejorada del Crossbeam 750 apunta a estos parámetros de rendimiento, especialmente para nodos semiconductores avanzados y la investigación de materiales de alta precisión.
Al combinar imagen y fresado simultáneos con un rendimiento óptico mejorado, el Crossbeam 750 responde a las necesidades en evolución en la fabricación y el análisis a escala nanométrica, donde el control del proceso y la fidelidad de imagen impactan directamente los resultados.
Editado por Natania Lyngdoh, Editora de Induportals — Adaptado por IA.
www.zeiss.com

